半導體芯片制造中“退火工藝(Thermal Annealing)”技術的詳解
轉:愛在七夕時
退火工藝(Thermal Annealing)技術是半導體制造中的一個關鍵步驟,它通過在高溫下處理硅片來改善材料的電學和機械性能。退火的主要目的是修復晶格損傷、激活摻雜劑、改變薄膜特性以及形成金屬硅化物。隨著半導體技術的不斷發展,特別是特征尺寸的持續減小,對退火工藝(Thermal Annealing)技術的要求也越來越高。本期中主要跟大家分享的是:退火工藝(Thermal Annealing)技術的基本原理、關鍵參數、不同類型及其在現代半導體制造中的應用。
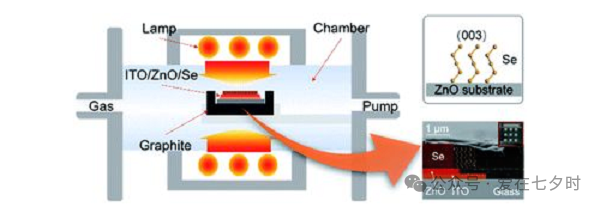
一、退火工藝(Thermal Annealing)技術的介紹
退火工藝又稱為熱退火,英文全稱:Thermal Annealing,其過程是將硅片放置于較高溫度環境中一定的時間,使硅片表面或內部的微觀結構發生變化,以達到特定的工藝目的。退火工藝的最關鍵的參數為溫度和時間,溫度越高、時間越長,熱預算(Thermal Budget)越高。在實際集成電路制造工藝中,熱預算都有嚴格的控制。如果工藝流程中有多步退火工藝,則熱預算就可以表達為多次熱處理的疊加,即:DT(eff)=DT(1)+DT(2)+…+DT(n)。
隨著工藝節點的微縮,在整個工藝過程中容許的熱預算越來越少,即高溫熱過程的溫度變低、時間變短。通常,退火工藝是與其他工藝(如離子注入、薄膜沉積、金屬硅化物的形成等)結合在一起的,最常見的就是離子注入后的熱退火。離子注入會撞擊襯底原子,使其脫離原本的晶格結構,而對襯底晶格造成損傷。熱退火可修復離子注入時造成的晶格損傷,還能使注入的雜質原子從晶格間隙移動到晶格點上,從而使其激活。晶格損傷修復所需的溫度約為 500°C,雜質激活所需的溫度約為950°C 。
理論上,退火時間越長、溫度越高,雜質的激活率越高,但是過高的熱預算將導致雜質過度擴散,使得工藝不可控,引發最終的器件和電路性能退化。因此,隨著制造工藝的發展,傳統的長時間爐管退火已逐漸被快速熱退火(Rapid Thermal Annealing, RTA)取代。在制造工藝中,某些特定的薄膜在沉積后需要經過熱退火過程,以使薄膜的某些物理或化學特性發生變化。例如,疏松的薄膜變得致密,改變其在干法刻蝕或濕法刻蝕時的速率;或者在高k柵介質生長后進行退火 (Post Deposition Annealing, PDA),改善高k介質的特性,可降低柵泄漏電流,并提高介電常數。還有一種使用得較多的退火工藝發生在金屬硅化物 (Silicide)形成過程中。
金屬薄膜如鈷、鎳、鈦等被濺射到硅片表面,經過較低溫度的快速熱退火,可使金屬與硅形成合金。某些金屬在不同的溫度條件下形成的合金相不同,一般在工藝中希望形成接觸電阻和本體電阻均較低的合金相。如前所述,根據熱預算需求的不同,退火工藝分為高溫爐管退火和快速熱退火。高溫爐管退火是一種傳統的退火方式,其溫度較高且退火時間較長,熱預算很高。在一些特殊的工藝中,如注氧隔離技術 ( Seperation by Implantation of Oxygen,SIMOX)制備 SOI 襯底、深n井(Deep n-Well)擴散驅入 (Drive-in)工藝中應用較多,此類工藝一般需要通過高的熱預算來獲得完美的晶格或均勻的雜質分布。
快速熱退火是用極快的升/降溫和在目標溫度處的短暫停留對硅片進行處理,有時也稱快速熱過程 ( Rapid Thermal Processing, RTP)。在形成超淺結過程中,快速熱退火在晶格缺陷修復、雜質激活、雜質擴散最小化三者之間實現了折中優化,在先進技術節點的制造工藝中必不可少。升/降溫過程及目標溫度短暫停留共同組成了快速熱退火的熱預算。傳統的快速熱退火溫度約為1000°,時間在秒量級。

二、退火工藝(Thermal Annealing)技術的基本原理
退火工藝的本質是在高溫下通過熱能驅動材料內部的原子重新排列,以達到特定的物理和化學變化。主要涉及以下幾個方面:
1、晶格損傷修復
離子注入:在離子注入過程中,高能離子轟擊硅片,導致晶格結構破壞,形成非晶態區域。
退火修復:通過高溫退火,非晶態區域的原子重新排列,恢復晶格的有序性。這一過程通常需要的溫度范圍在500°C左右。

2、雜質激活
摻雜劑遷移:退火過程中,注入的雜質原子從晶格間隙遷移到晶格位置,形成有效的摻雜。
激活溫度:雜質激活通常需要更高的溫度,大約950°C。溫度越高,雜質的激活率越高,但過高的溫度會導致雜質過度擴散,影響器件性能。

3、薄膜改性
致密化:退火可以使疏松的薄膜變得致密,改變其在干法刻蝕或濕法刻蝕時的速率。
高k柵介質:在高k柵介質生長后進行退火(Post Deposition Annealing, PDA),可以改善介質的特性,降低柵泄漏電流并提高介電常數。
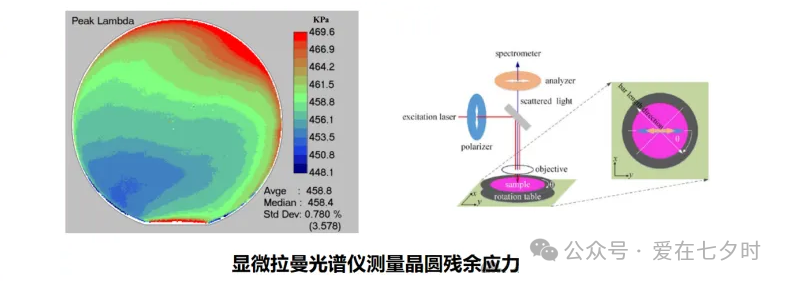
4、金屬硅化物形成
合金相:金屬薄膜(如鈷、鎳、鈦)與硅反應形成合金,退火過程中不同的溫度條件會導致不同的合金相形成。
優化性能:通過控制退火溫度和時間,可以形成接觸電阻和本體電阻均較低的合金相。
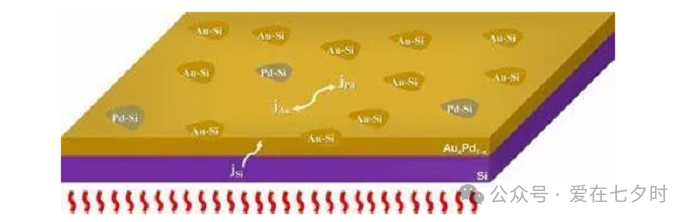
三、退火工藝(Thermal Annealing)技術的關鍵參數
1、溫度
溫度是退火工藝中最關鍵的參數之一。不同的退火目的需要不同的溫度范圍。例如,晶格損傷修復通常需要500°C左右的溫度,而雜質激活則需要950°C左右的溫度。
2、時間
退火時間與溫度密切相關。時間越長,熱預算越高,但過長的時間會導致雜質過度擴散。因此,需要在時間和溫度之間找到最佳平衡點。
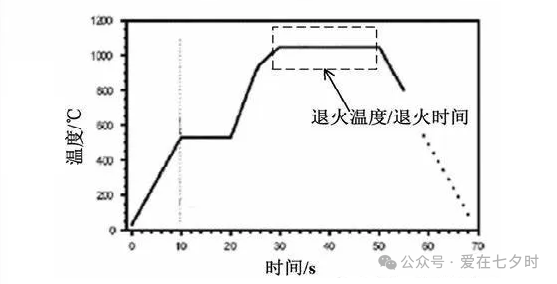
3、熱預算(Thermal Budget)
熱預算是指在整個制造過程中累積的熱量影響。隨著技術節點的縮小,允許的熱預算越來越少,需要通過優化退火工藝來減少不必要的雜質擴散。
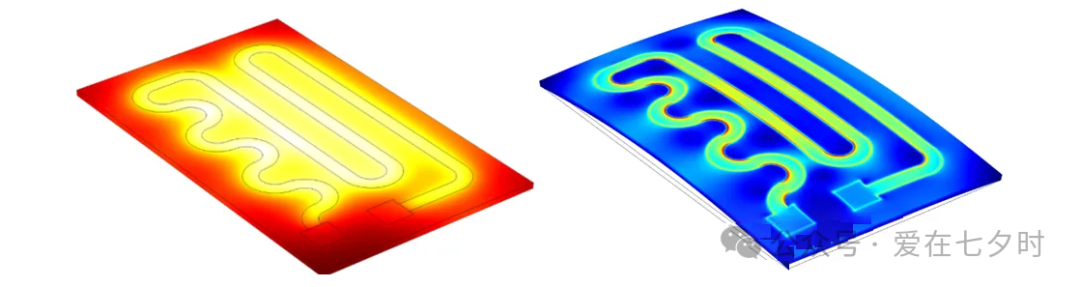
四、退火工藝(Thermal Annealing)技術的類型
1、高溫爐管退火(High-Temperature Furnace Annealing)
特點:傳統的退火方法,溫度較高(通常超過1000°C),退火時間較長(數小時)。
應用:適用于需要高熱預算的應用場景,如SOI襯底的制備和深n井的擴散。

2、快速熱退火(Rapid Thermal Annealing, RTA)
特點:利用快速升溫和降溫的特點,能夠在較短時間內完成退火,通常溫度在1000°C左右,時間在秒量級。
應用:特別適合于超淺結的形成,能夠有效減少雜質的過度擴散,是先進節點制造不可或缺的一部分。

3、閃光退火(Flash Lamp Annealing, FLA)
特點:使用高強度閃光燈在極短時間內(毫秒量級)加熱硅片表面,實現快速退火。
應用:適用于20nm以下的線寬的超淺的摻雜激活,能夠最小化雜質擴散,同時保持高的雜質激活率。

4、激光尖峰退火(Laser Spike Annealing, LSA)
特點:使用激光光源在極短的時間內(微秒量級)加熱硅片表面,實現局域化和高精度的退火。
應用:特別適用于需要高精度控制的先進工藝節點,如FinFET和high-k/金屬柵極 (HKMG)器件的制造。
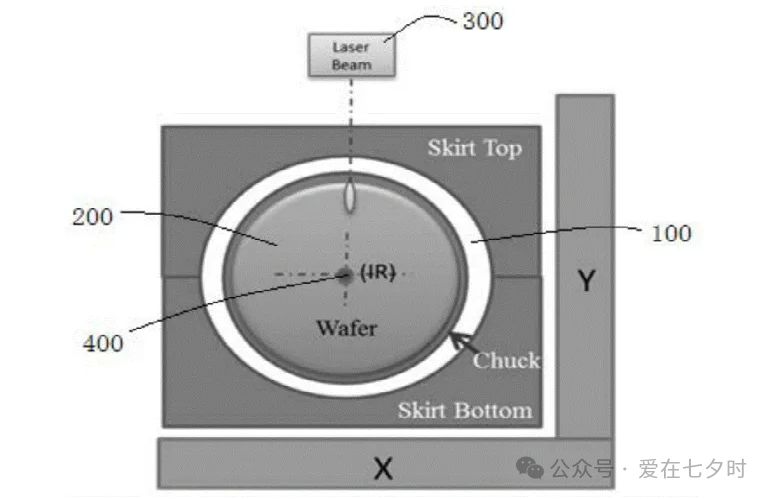
五、退火工藝(Thermal Annealing)技術的應用
1、超淺結形成
隨著技術節點的縮小,超淺結的形成成為關鍵挑戰。RTA和FLA等快速退火技術能夠在保持高雜質激活率的同時,最小化雜質擴散,確保器件性能。
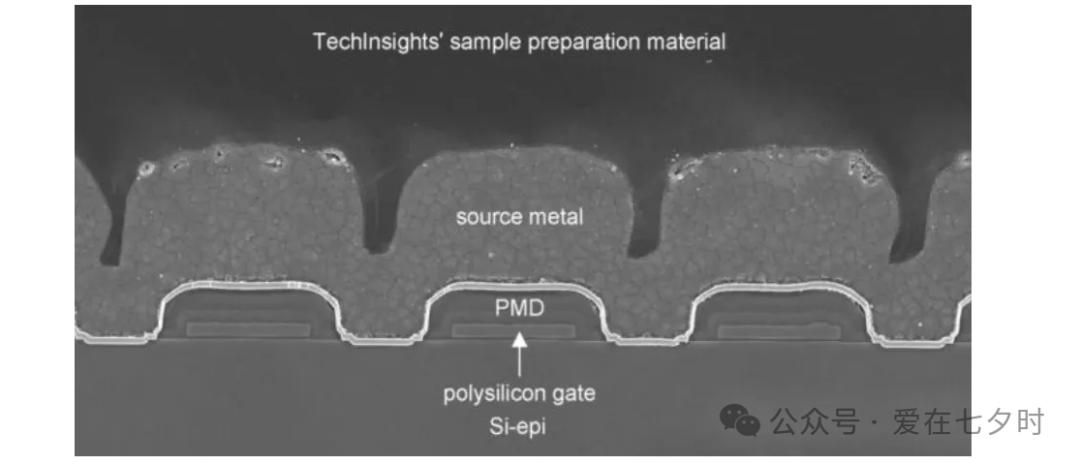
2、高k柵介質的改性
在高k柵介質生長后進行PDA,可以顯著改善介質的電氣性能,降低柵泄漏電流并提高介電常數。這在先進邏輯和存儲器件中尤為重要。
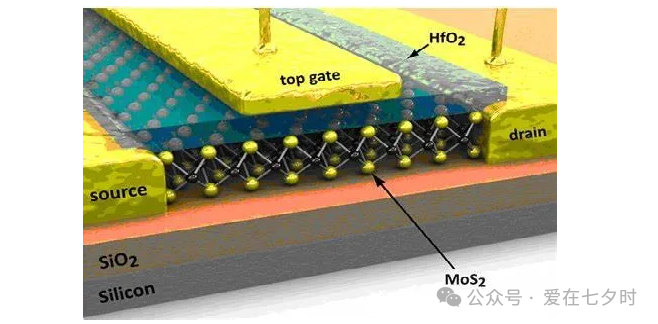
3、金屬硅化物的形成
金屬硅化物(如CoSi、NiSi)在接觸電阻和本體電阻方面的優化對于提高器件性能至關重要。通過精確控制退火條件,可以形成理想的合金相。
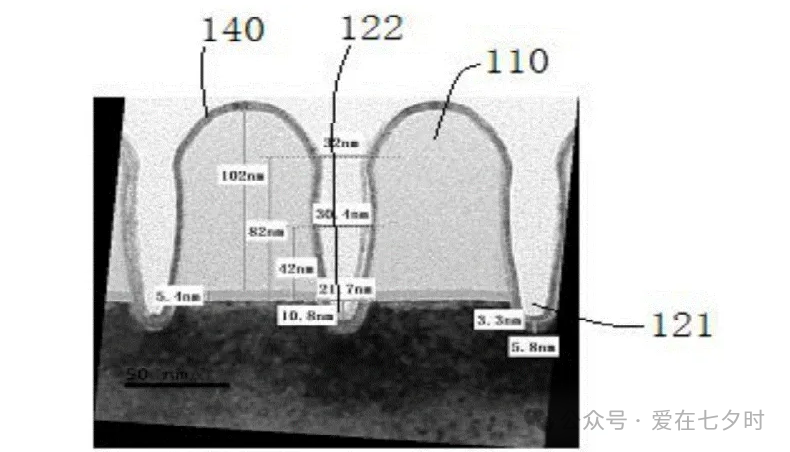
4、三維集成技術
在三維集成技術中,如3D NAND和3D DRAM,退火工藝需要在多個層次上進行,確保每一層的性能都達到最佳。快速退火技術在這一過程中發揮著重要作用。

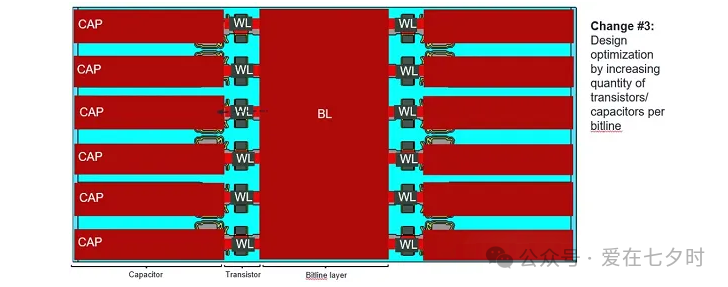
總結一下
退火工藝(Thermal Annealing)技術在半導體制造中扮演著至關重要的角色,通過對溫度、時間和熱預算的精確控制,可以實現晶格損傷修復、雜質激活、薄膜改性和金屬硅化物形成等多種功能。近年來對其要求越來越嚴格,逐漸發展出閃光退火(Flash Lamp Annealing, FLA)、尖峰退火(Spike Anneal)及激光尖峰退火(Laser Spike Annealing, ISA),退火時間達到了毫秒量級,甚至有向微秒和亞微秒量級發展的趨勢。激光退火最獨特的優點是空間上的局域性和時間上的短暫性,采用激光光源的能量來快速加熱晶片表面到臨界熔化點溫度。由于硅的高熱導率,硅片表面可以在約 0. 1ns時間內快速降溫冷卻。激光退火系統可以在離子注入后以最小的雜質擴散激活摻雜物離子,已被用于 45nm 以下工藝技術節點。激光退火系統可與尖峰退火系統一起使用,以實現最優的結果。未來,隨著新材料和新器件的不斷涌現,退火工藝(Thermal Annealing)技術將繼續創新和發展,以滿足更高的性能要求。



